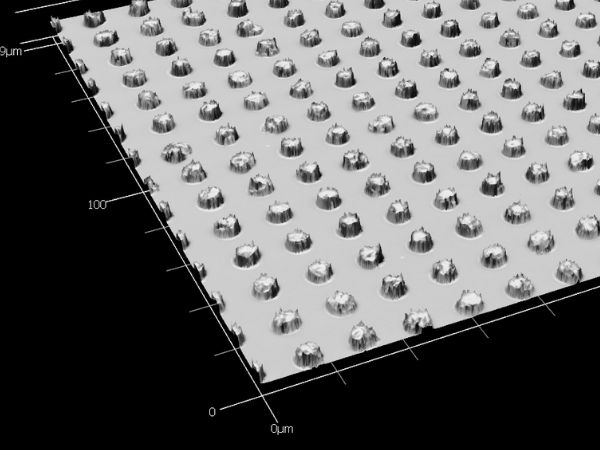
インジウムバンプインターコネクト(IBI)フリップチップボンディング
大型チップにおける高画素数化 / Qubit数増加と相互接続密度の増大により、ハイブリッド化とモノリシック集積化が進んでいます。その結果、ファインピッチ・マイクロ・インジウム・バンプ・インターコネクト(IBI)フリップチップ・ダイボンディング・ソリューションの需要が高まっています。
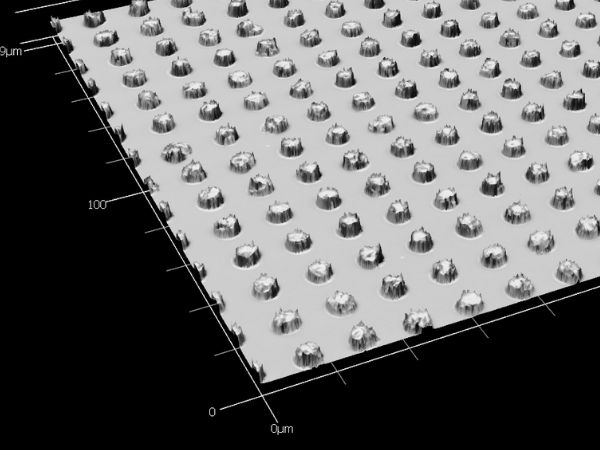
大型チップにおける高画素数化 / Qubit数増加と相互接続密度の増大により、ハイブリッド化とモノリシック集積化が進んでいます。その結果、ファインピッチ・マイクロ・インジウム・バンプ・インターコネクト(IBI)フリップチップ・ダイボンディング・ソリューションの需要が高まっています。
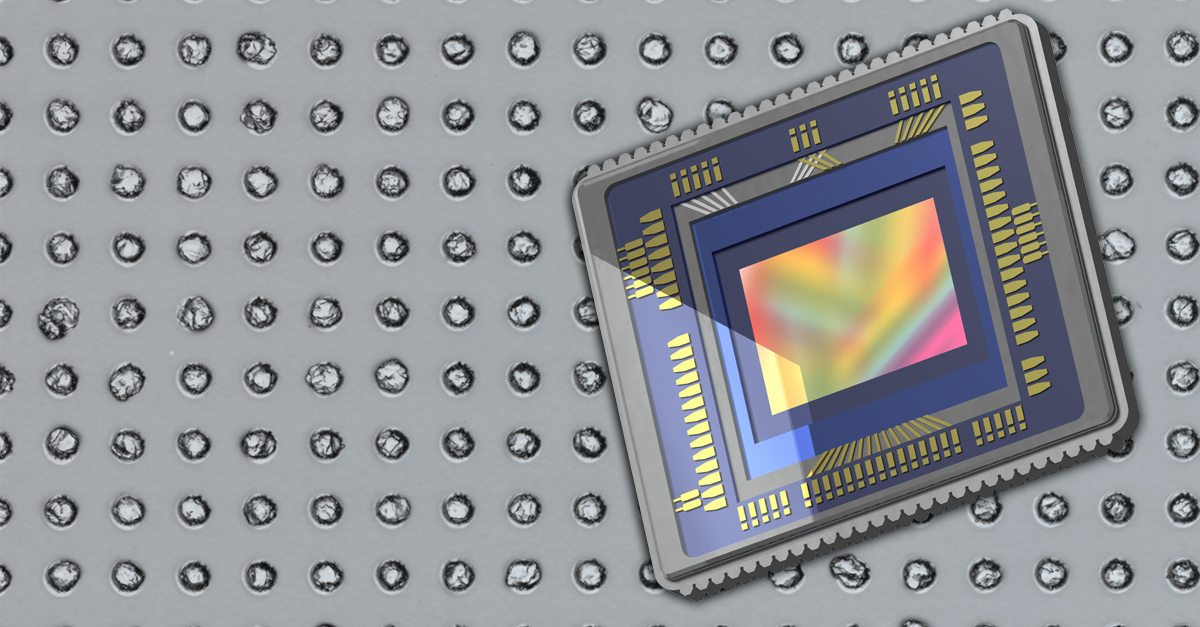
業界要求を踏まえると、大型かつ高密度な赤外線(IR)サーマルイメージセンサー(熱画像センサー)の製造する際に用いるべき接合方法は、狭ピッチなマイクロインジウムバンプアレイ同士を相互接続するタイプのボンディングです。しかし、インジウムバンプ間のダイボンディングには特有の課題があります。)
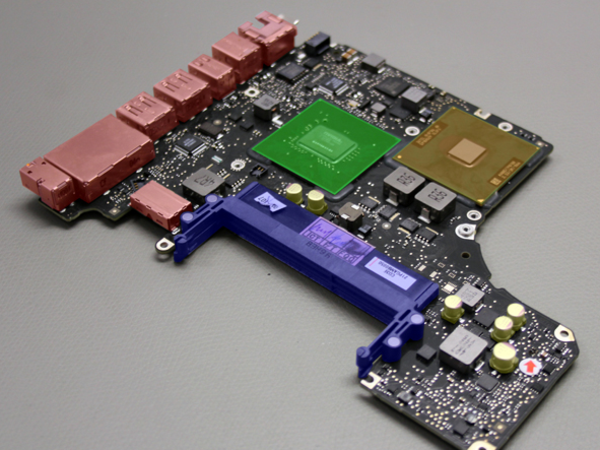
大型ボールアレイを持つBGA部品、プロセッサユニット(CPU)、グラフィックスチップ(GPU)、ファインピッチアレイを持つCSPなどのリワークには、精密な熱管理と高い搭載精度、高解像度光学系を組み合わせた特殊なデバイス構成が必要です。

当社の技術文章では、特定のアプリケーションとプロセスに関する基礎知識をコンパクトで分かりやすく提供し、それらの具体的の要件に適した製品ソリューションを紹介しています。

試作製品開発および量産のためのファインテック社のリワークシステムは、現代のディスプレイシステムに組み込まれている SMD LED (RGB)のような形態のミニチュア LED のリワークの目的に適しています。

I/Oパッド数の増加した一般的ICパッケージングにおいては、大量生産、製造コストの増大、ボンディング抵抗の増加、一般的実装仕様に伴う寄生インダクタンスなどを考慮しなくては…
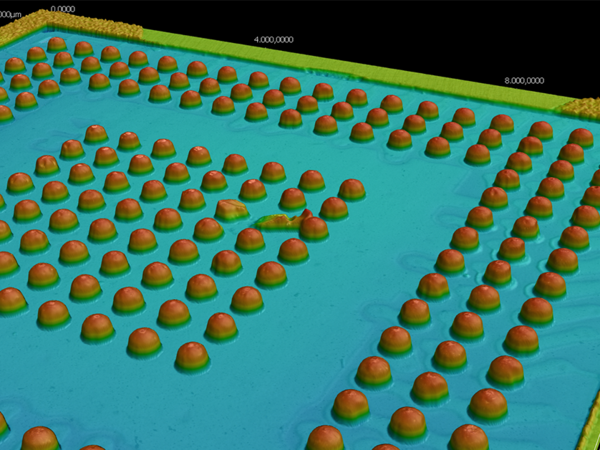
一つのはんだボールの欠陥は、BGAパッケージ全体を使用不能にするのに十分です。単一のはんだボールを交換する機能により、特に価値のあるパッケージやレガシーパッケージを救うことができます。

新しいはんだボールアレイを正確に配置することをアレイリボールと呼びます。このリペアプロセスは、貴重な資源(とコスト)の節約が重要な場合や、バリューチェーンを拡張する必要がある場合に用いられます。
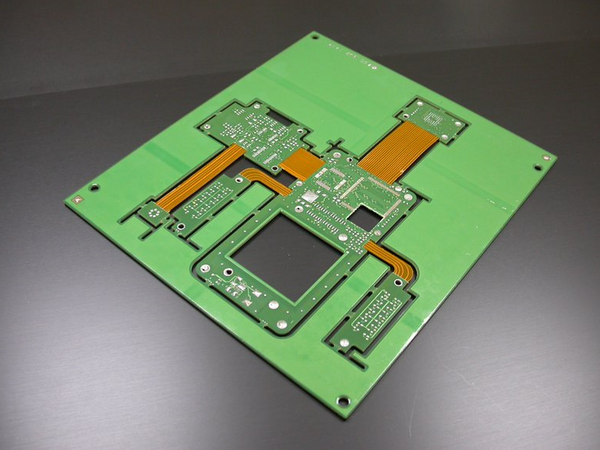
フレキシブル基板は、3次元的な接続やメカトロニクスのコンセプトで使用され、必要なコネクタの数を減らすことができます。彼らは非常に動的な曲げ動作に耐えることができ、高速相互接続が可能です。