New video: See the FiNEXT P3 next-generation production die bonder in action
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
March 2026 – Check out this video of the upcoming high-mix volume die bonding platform FiNEXT P3, which is currently in development at Finetech.
The calibration pick and place dry cycle is to test and ensure reliable 3 micron placement accuracy across the entire work area. Also shown is wafer loading from the new multi-slot wafer magazine, as well as die pick-up from the die eject module.
With full 12-inch support and a 13-slot wafer magazine, the FiNEXT P3 is optimally prepared for sequential assembly processes at wafer level. Dies can be picked up from the source wafer either face-up or in flip-chip orientation using the die-flip module.
Stay tuned for more news and videos as development continues.
New blog: Learn more about the thinking behind our development of the next generation of production die bonders
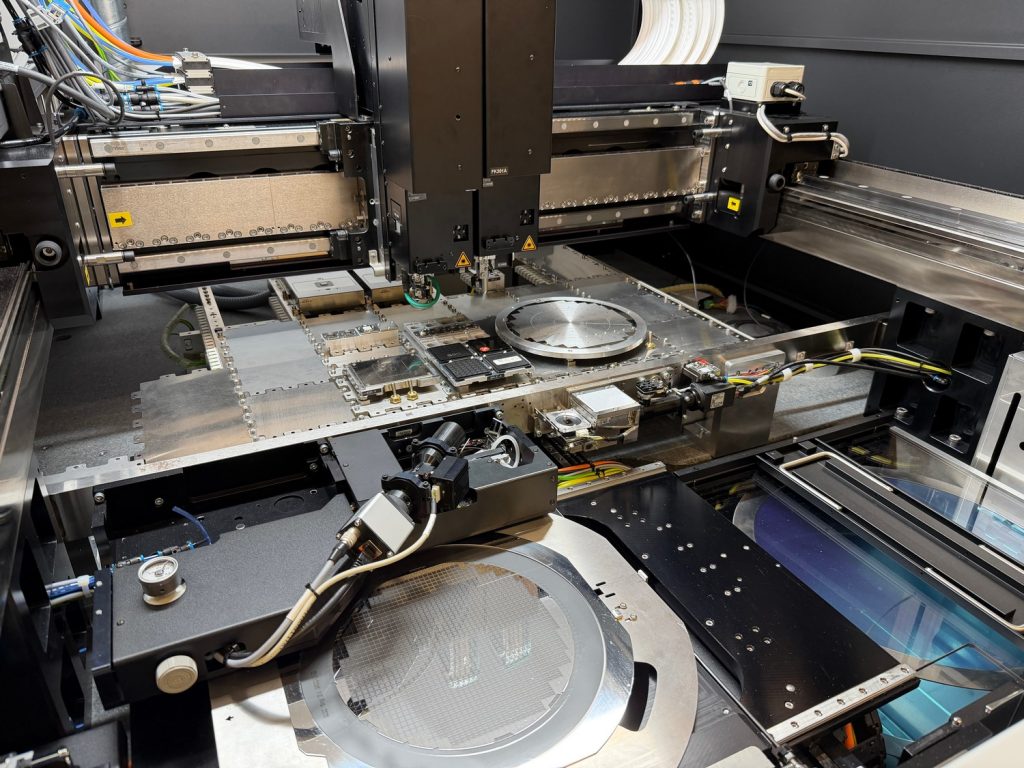
March 2026 – Advanced packaging is moving toward larger wafer formats, higher integration density, and more complex device architectures. As photonic modules, power devices, and heterogeneous packages add new layers of process complexity, production stability is becoming a defining capability for manufacturers scaling assemblies beyond R&D into reliable volume production.
At the same time, expectations are shifting toward automated workflows and 12-inch compatible manufacturing, driven by new fab and pilot line investments worldwide. Production environments must handle more materials, more bonding processes, and tighter tolerances while maintaining yield and repeatability.
We began asking a simple question: what would a production die bonder look like if it were designed from the start to manage this variability without sacrificing stability? That question led to the development of our next-generation production die bonding platform.
News: read the official press release on the FiNEXT P3 beta prototype

February 2026 – Following an exclusive first look at Productronica 2025, Finetech has officially unveiled the beta prototype of its next-generation production die bonder platform. The modular system FiNEXT P3 supports multiple bonding technologies and 12-inch wafers, enabling manufacturers to consolidate diverse advanced packaging processes in a single platform.
The automated production die bonder is designed for flexible yet stable and repeatable assembly workflows, using 12-inch wafers as both source and target. This enables semiconductor, photonics and sensor manufacturers to address demanding applications in advanced 2.5D and 3D packaging, heterogeneous integration, hybrid bonding and direct bonding.
Development continues to evolve with production customer feedback. Increasing expectations for yield, quality and high-volume output are driving demand for scalable, automation-ready systems capable of handling new materials and more complex assembly architectures.
Our new production die bonder: exclusive first look at Productronica 2025

The system features automated wafer and die handling on a high-precision gantry, enabling efficient, repeatable workflows and supporting scalable manufacturing. It is being designed to incorporate ultrasonic bonding as its initial process capability and provides an open platform architecture to accommodate diverse process requirements.
Visitors will have the opportunity to preview the concept and share direct feedback, helping to shape the platform’s final design.


